정보기술(IT) 시장에 관심 많으신 독자 여러분, 안녕하세요. 지난달 25일 한 장의 사진이 시선을 사로잡았습니다.
사진의 제목은 '일본 출장 마친 뒤 귀국한 경계현 삼성전자 사장.' 삼성전자 반도체(DS) 부문을 총괄하는 경계현 사장이 나흘 간의 일본 출장을 마치고 김포비즈니스항공센터를 통해 입국하는 장면이 포착됐죠.
사실 경계현 사장의 이번 일본 방문은 이미 출장 전부터 서울경제신문의 단독 기사로 예고된 바 있습니다. 경 사장 외에도 삼성의 차세대 반도체 연구를 책임지는 송재혁 삼성반도체연구소장(사장), 반도체 라인 기술을 총괄하는 남석우 제조담당 사장, 생산 설비에 필요한 소재·부품·장비 구매를 총괄하는 박진영 부사장까지 삼성 반도체를 책임지는 고위 임원들이 한꺼번에 일본으로 향했던 것이 특징이었습니다.
그럼 삼성의 톱 경영진은 왜 한꺼번에 일본으로 갔을까. 일본의 어떤 업체들과 미팅을 갖고 무슨 대화를 나눴을까. 요즘 아주 핫하게 떠오르고 있는 삼성 반도체 부문 일본 협력사 리스트를 살펴 보면서 이들의 동선을 짐작하고 추정해봤습니다.
이번 기사는 삼성 반도체 경영진의 이번 일본 출장 일정과 내용을 조목조목 정확하게 들여다보는 것 보다는, 삼성전자가 준비하고 있는 미래 반도체 기술 이야기를 풀어가면서 회사가 가지고 있는 일본 공급망의 영향력과 중요성에 초점을 맞췄습니다. 총 3편으로 구성했습니다. 그럼 우선 장안의 화두 고대역폭메모리(HBM) 생태계부터 들어가 보겠습니다.
◇삼성 첨단 HBM·패키징, 日 장비에 달렸다 (feat. 신카와, 레조낙, 디스코)
요즘 메모리 반도체 업계는 HBM 없이는 얘기가 안되죠. 삼성전자가 과연 SK하이닉스의 HBM 1위 자리를 빼앗을 수 있을까. 엔비디아가 과연 삼성전자의 HBM을 언제부터 쓸 것인가. 삼성전자와 SK하이닉스의 대결 구도, 각종 추측과 분석이 메모리 업계를 뜨겁게 달궜습니다.
삼성전자는 HBM 라이벌 SK하이닉스와 제조 기술이 다르다는 게 가장 큰 특징입니다. 삼성전자는 HBM 생산에서 기존 방식인 열압착(TC·Thermal Compression) 방식을 고수합니다. D램과 D램 사이에 전기가 통하지 않으면서 빈 공간을 채워주는 비전도성필름(NCF)을 넣고 마치 다림질할 때처럼 칩 위를 열과 압력으로 꾹 눌러 결합하는 방식이죠.
반면에 SK하이닉스는 5세대 HBM(HBM3E)부터 마치 도자기 굽듯 칩과 칩을 연결하는 새로운 '매스리플로우(MR)-MUF' 방식을 씁니다. 일단 D램을 쌓아서 가교(범프)를 연결해놓고 그 사이에 끈적끈적한 본드를 채운 후 한증막같은 리플로우 장비에 넣어서 굳히는 방식인데요.
업계를 취재해보니 삼성전자가 TC 본딩을 고수하는 주요한 이유는요. HBM 공정 중 발생하는 개별 D램 칩의 '휨(Warpage)' 현상을 최소화할 수 있다는 것을 봤기 때문이라고 합니다. 요즘 HBM은 용량 개선을 위해 8단에서 12단으로 더 많은 D램을 적층하는 추세죠? 똑같은 720마이크로미터(㎛) 수준의 HBM 두께 조건에 8개→12개 D램을 쌓아 올려야 합니다. 그러려면 D램을 아주 얇게 갈아낼 수밖에 없습니다.
그런데 MR-MUF 공정으로 D램 칩에 열을 가하는 상황을 볼까요. 두께가 얇아지다보니 사방에서 들어오는 열에 더 취약해져서 공정 중 칩이 일그러지거나 휘어질 확률이 더욱 커진다는 단점이 생깁니다. 반면 TC-NCF 본딩 방식은 칩 위에서 적당한 압력이 가해지는 것이기 때문에 열이 가해지더라도 원래의 빳빳한 상태를 유지할 수 있다는 것이 삼성의 논리라는 겁니다. 고층 HBM으로 가더라도, 쉽게 말해 다림질을 할 수 있으니까 얇아지는 D램을 잘 보호할 수 있다는 거죠.
아무튼 이러한 판세를 놓고 보면 삼성전자에 있어 HBM 제조에서 '다리미' 역할을 해주는 TC 본딩 장비가 무척 중요해 보입니다. 이 장비를 일본 신카와에서 가져옵니다. 삼성전자의 반도체 장비 계열사 세메스도 물론 삼성 HBM TC 본더 공급망에 포함돼 있지만, 삼성 경영진이 신카와에 보내는 신뢰는 꽤 높은 것으로 알려져 있습니다. 신카와의 본딩 장비는 HBM 외에도 삼성전자가 상당히 공을 들이고 있는 어드밴스드 패키징(AVP), 2.5D 패키징에도 아주 요긴하게 쓰이는 설비라고 하죠.
삼성전자는 올해 HBM 생산 설비를 전년 대비 2.5배 늘리는 것을 목표로 이 시장에 상당히 적극적으로 나서고 있습니다. 최근 HBM 씬(scene)에서 갈수록 커지고 있는 SK하이닉스의 영향력·D램 3위 마이크론 테크놀로지의 발빠른 진입 등으로 삼성만의 킬링 포인트가 필요한 가운데 핵심 장비사인 일본 신카와와 수급 논의, 공동 기술 개발을 보장하는 돈독한 관계는 무척이나 중요해 보이죠.
신카와 외에도 삼성 HBM 서플라이 체인 중에서 일본 기업의 존재감은 큽니다. 조금 전 TC 본딩에 꼭 필요한 접착 필름 'NCF'에 대한 이야기도 드렸죠. D램 사이를 채우면서 절연성도 좋은 이 필름은 일본의 레조낙(옛 쇼와덴코)이라는 회사가 삼성전자와 두터운 파트너십을 유지하고 있습니다. 또 각 D램 다이의 뒷부분을 갈아내 얇게 만드는 '그라인딩' 장비에 대한 언급도 드렸는데요. 이렇게 웨이퍼 뒤를 갈면서 칩 형태로 아주 미세하게 자르는 '다이싱' 작업을 잘하는 장비 분야도 일본의 디스코라는 회사가 삼성전자와 끈끈한 협력을 맺고 있습니다.
이제 2편에서는 일본 굴지의 반도체 장비 회사 도쿄일렉트론(TEL)의 차세대 낸드플래시 식각 기술에 대해 알아보려고 합니다. 다음 편은 2월 11일 오전 7시에 나옵니다. 기대해주시고 행복한 명절 되세요.
< 저작권자 ⓒ 서울경제, 무단 전재 및 재배포 금지 >










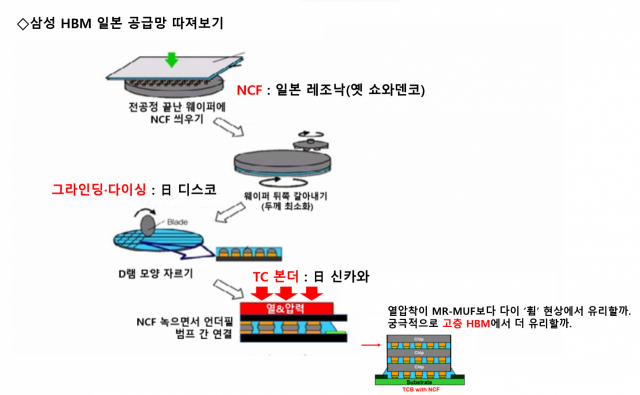
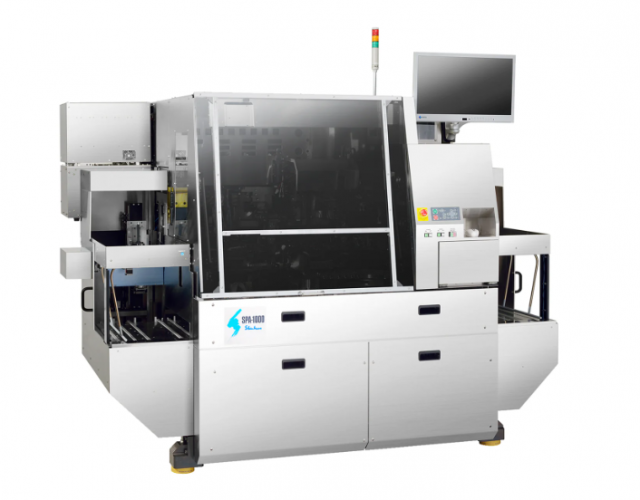

 hr@sedaily.com
hr@sedaily.com









































